特点及应用
特点
- 该类型外壳属于一体化封装,通常用于实现SIP模块
- 模块将基板与封装集成为一体,内部封装数个RF、DSP、ADC、DAC、SRAM、CPU、FPGA、阻容等元器件。
- 该结构可以实现更好的封装密度,更好的系统性能,与常规的金属管壳结合MCM-C基板的封装结构相比,具有体积小、封装密度高、重量轻、性能优秀等特点
- 可依据用户的需求进行定制。
- 三维空间布线、高密度电路集成、封装效率高
- 定制化结构设计、焊点设计灵活
- 多层共烧工艺,物理尺寸小
- 焊点少,连接路线短,电性能表现优异
- 高导热,各定制各类热沉结构
- 可靠性高,气密性好
- 成本较LTCC较大优势
应用
- 主要用于射频电路、数字信号处理、高性能模拟电路集成等高密度集成电路系统,是当前系统集成的发展趋势之一
DPC & AMB
DPC 陶瓷基板
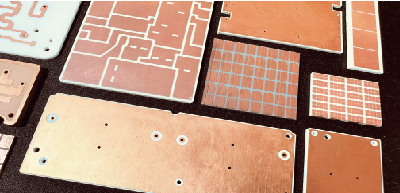
产品特点
- 基于高性能陶瓷材料:AL2O3、AIN、Si3N4、ZTA、高Q介质陶瓷等
- 高可靠性磁控溅射和电镀工艺
- 可选熟瓷激光成型工艺:高效低成本
- 可选生瓷成型工艺:高品质通孔和边缘质量
- 基材厚度范围0.3-3mm
- 镀层Cu、Ag、Sn、Ni、Au最大镀层厚度100um
应用
- 大功率激光器热沉、LED Submount、高导热热沉基板
- 无线通讯、射频微带电路
AMB 陶瓷基板
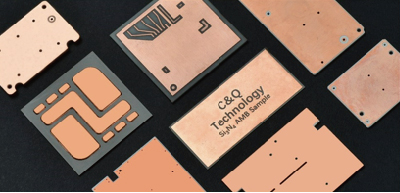
产品特点
- 基于高导热陶瓷材料:Si3N4、AlN、Al2O3等
- 高可靠性AMB钎焊浆料体系
- 基材厚度范围0.3-3mm
- 铜箔厚度100-800um
- 支持表面处理:Cu、Ag、Sn、Ni、Au
应用